存储器作为信息技术发展的基石,根据其数据读写方式可分为只读存储器和随机读写存储器,根据数据存储时间又可分为易失性存储器和非易失性存储器。 目前市场主流的存储器仍以非易失性存储器为主,但其固有的缺陷已经不能满足信息技术对于存储器的要求, 亟需开发新型的读取速度快、存储密度大以及功耗低的高性能器件。 为了解决这一问题,新型非易失性存储器如铁电存储器、磁阻存储器、 相变存储器和阻变存储器等被广泛研究。阻变存储器因其结构简单、读写速度快(亚纳秒级)、可缩小性强且与CMOS 工艺兼容等优点,被认为是下一代非易失性存储器最有潜力的取代者之一。 阻变存储器单元结构多采用简单的MIM 结构。阻变效应是指材料在不同电压下呈现高低电阻态,且分为单极型阻变和双极型阻变。 氧化物半导体材料因其材料稳定、组分多样化、成品率高、与CMOS 工艺兼容等优点,被广泛应用于阻变存储器的研究。
1 氧化物阻变介质材料
氧化物薄膜材料具有良好的稳定性和电学特性, 在微电子器件和柔性电子器件领域具有广泛的应用[1]。 众多研究报道金属氧化物材料具有很好的电阻开关特性,其中多为过渡金属氧化物和镧系金属氧化物,本文归纳了常见的几种氧化物阻变介质材料,例如氧化铪(HfOx)、氧化铝(AlOx),氧化镍(NiOx),氧化钛(TiOx),氧化锌(ZnO)和氧化钽(TaOx)等材料。
1.1 氧化铪阻变材料
氧化铪材料的禁带宽带为5.5 eV,单斜相HfOx的相对介电常数达17,是一种优异的高介电常数材料, 被广泛用于微电子MOSFET 器件的栅介质层。此外, 研究发现缺陷较多的HfOx 材料具有非常好的阻变特性。 HfOx 基阻变存储器具有读写速度快、低功耗和高稳定性的优势。2007 年,Park 等[2]首次提出HfOx 材料具有电阻开关特性,HfOx 材料在电场的作用下更易产生薄膜内部缺陷,从而引起材料的阻变存储特性。 HfOx 材料与常用的氮化物金属电极均可通过原子层沉积工艺(atomic layer deposition,ALD)制备, 与CMOS 工艺结合可实现三维存储阵列。 早期HfOx 基阻变存储器研究多采用TiN/HfOx/Pt 结构,实现双极型阻变存储器。 其中TiN 易耗尽HfOx 材料表面的氧, 在HfOx 薄膜内部产生额外的氧空位从而实现HfOx 材料的电阻开关特性。Chen 等[3]提出在TiN 与HfOx 层插入一层Ti 金属帽层(图1(a)),通过后退火工艺处理, 利用Ti 金属帽层耗尽HfOx表面的氧,从而提升阻变存储器的性能。 同时,Lee等[4]也提出采用AlCu 和Ta 作为金属帽层具有类似的作用,基于该方法制备的阻变存储器读写速度可达10 ns,开关比为100,循环次数可以实现106 次,如图1(b)所示。 众多研究发现,单一HfOx 材料制备的阻变存储器具有小开关比和高读写电压的缺点,通过调控界面势垒可以显著提升阻变存储器性能。 Islam 等[5]采用磁控溅射在HfOx 薄膜与电极之间引入一层Ge2Sb2Te5 绝热层(图1(c)),在电场的作用下HfOx/Ge2Sb2Te5 薄膜具有更宽的导电细丝,使得HfOx 基阻变存储器具有更大的开关比和更快读写速度。Persson 等[6]通过在HfOx 薄膜上下界面引入超薄的氧化铝层, 精确调控氧空位导电细丝的形成与断裂过程,显著提升了HfOx 基阻变存储器的开关比,如图1(d~f)所示。 此外,离子掺杂工艺亦是改变材料特性的最简单方法,且可精确控制材料组分。常用的掺杂金属有Al、Cu、Ti、Ca 和Ta 等, 通过金属离子掺杂HfOx 薄膜能够有效地改变材料相稳定性和增加氧空位缺陷,从而显著提升器件性能。 Zhang等[7]采用气相化学沉积方法制备S 掺杂的HfOx 薄膜, 并发现S 掺杂能够提升HfOx 薄膜的氧空位浓度,从而提升HfOx 基阻变存储器的性能。
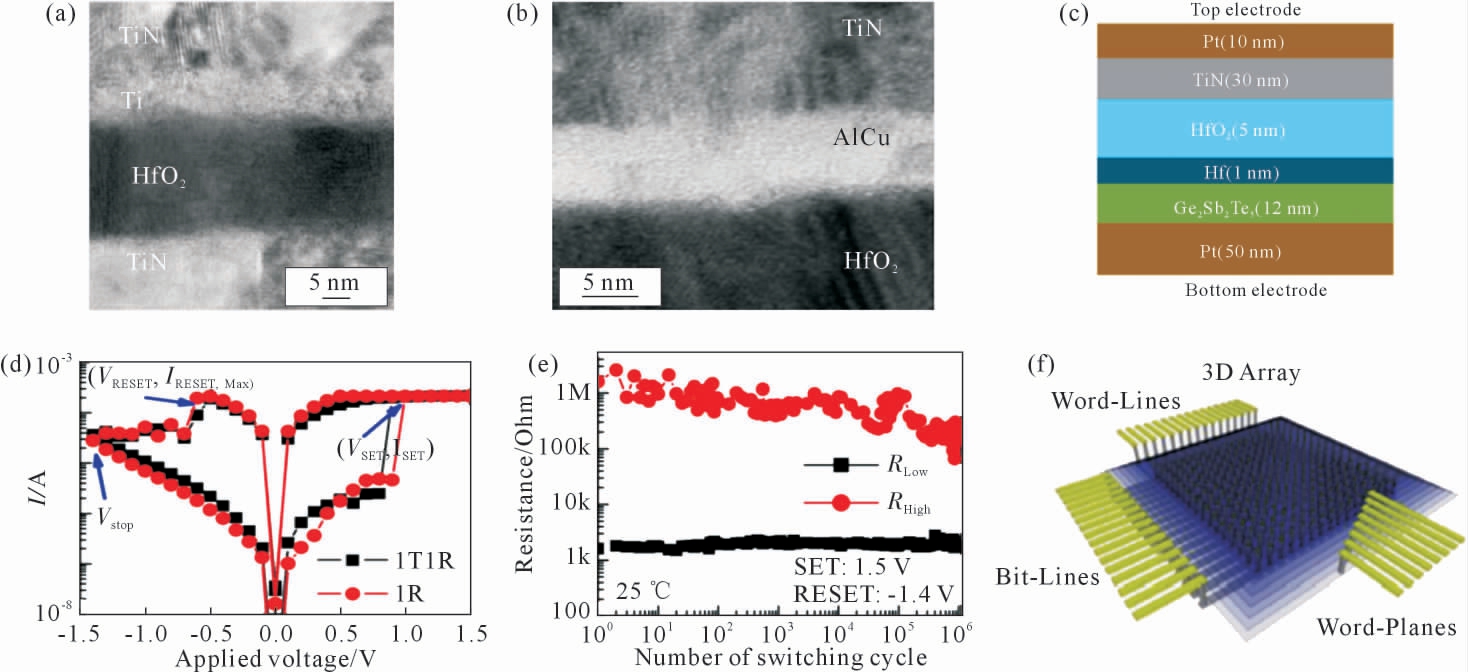
图1 HfOx 基阻变存储器:(a)Ti 帽层结构,(b)AlCu 帽层结构,(c)Ge2Sb2Te5 绝热层,(d)HfOx 基阻变存储器的I-V 曲线,(e)HfOx基阻变存储器的循环特性,(f)三维存储阵列[3-6]
Fig.1 RRAM based on HfOx materilas:(a)Ti buffer layer,(b)AlCu buffer layer,(c)Ge2Sb2Te5 thermal barrier,(d)I-V curves of HfOx RRAM,(e)endurance of HfOx RRAM,(f)RRAM memory array[3-6]
1.2 氧化铝阻变材料
氧化铝材料的禁带宽带为8.9 eV, 是一种优异的绝缘介质材料, 氧化铝也被广泛地用于微电子器件的栅介质层和封装层。 1962 年Hickmott 等[4]首次发现氧化铝材料具有负阻特性, 这一发现也为其应用于阻变存储器奠定了理论基础。相比于氧化铪材料,氧化铝较大的禁带宽度导致AlOx 基阻变存储器具有较低的操作电流(nA 级)。 Wu 等[9]基于Al/AlOx/Pt结构阻变存储器并采用Ti 帽层高温退火工艺处理(图2(a)),实现了1 μA 的低操作电流。Kim 等[10]采用磁控溅射在氮气下制备AlOx 薄膜, 在AlOx 薄膜中形成低浓度的AlN(图2(b)),从而实现更低的限制电流(100 nA)和开启电压。 氧化铝基阻变存储器具有较低的操作电流和MΩ 级的低阻态电阻,低漏电流也是其独特的优势。 Shen 等[11]研究不同退火温度对AlOx 薄膜材料的影响,并发现250 ℃退火的氧化铝材料在薄膜表面具有更多的金属羟基键和较小的薄膜粗糙度,相应的阻变存储器也表现出更小的开启电压和高开关比。 氧化铝材料也可以与其他阻变材料结合制备异质结介质层,以提升阻变存储器的性能和成品率。Yu 等[12]采用原子层物理沉积法制备HfOx/AlOx 异质结层(图2(c)),基于TiN/HfOx/AlOx/Pt结构首次制备双氧化物阻变存储器,并实现更优的开启电压和器件稳定性。Chen 等[13]采用原子层物理沉积制备超薄的HfOx/AlOx 异质结,并基于TiN/HfOx/AlOx/Ni结构制备的阻变存储器读写速度达40 ns,有望实现高速超大规模存储阵列,如图2(d)所示。Wu 等[14]采用物理气相沉积工艺制备AlOx/ZnO 异质结(图2(e)),并通过设计不同AlOx 薄膜厚度调控阻变存储器的性能, 基于Pt/AlOx/ZnO/Ti 结构实现低功耗的读写和高循环稳定性。Ismail 等[15]通过在TaN电极上沉积一层薄的AlOx 材料,在其界面处形成一层AlTaON 材料,并基于Pt/TiOx/AlOx/AlTaON/TaN结构实现低开启电压和低操作电流。 Yin 等[16]采用磁控溅射制备多层渐变的AlOx/HfOx 异质结(图2(f)),基于Pt/AlOx/HfOx/Ti 实现了多级阻变开关特性,有效降低了器件的读写电压和功耗,这一结果也为异质结阻变存储器提供了新思路。
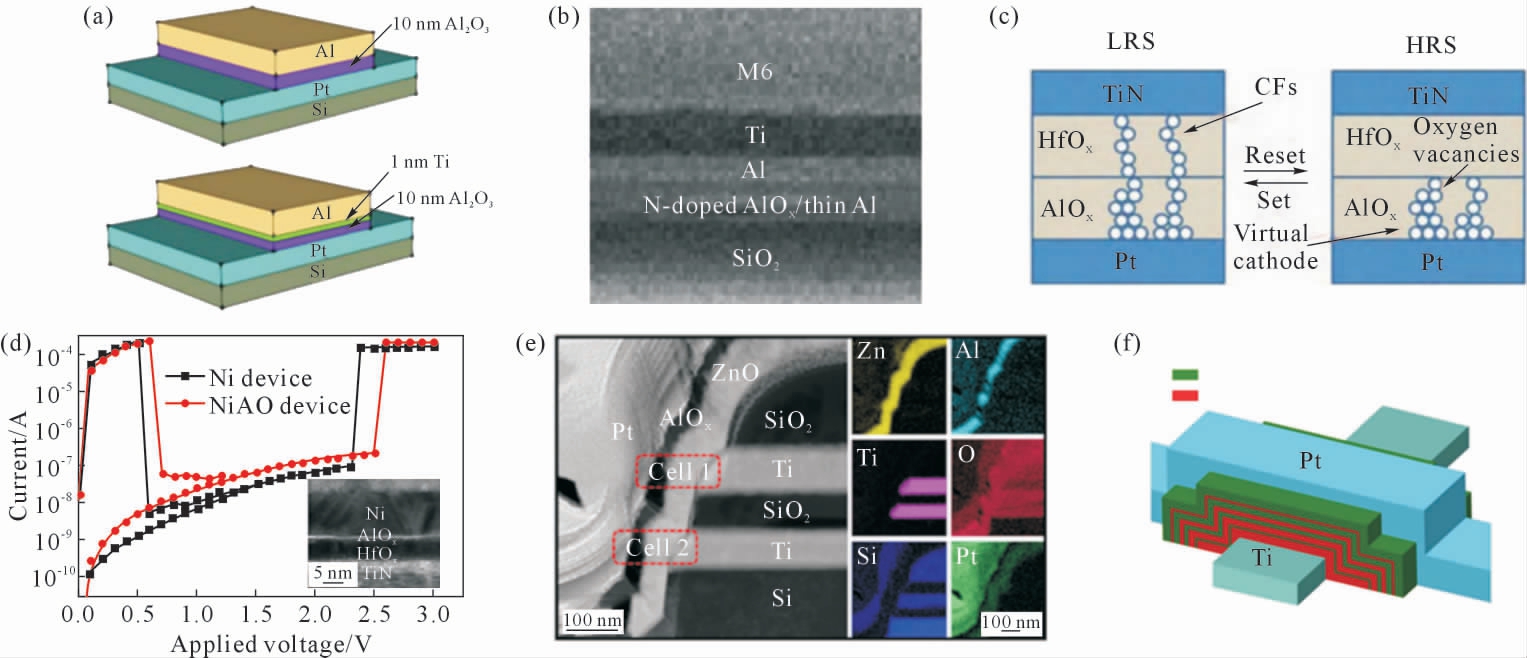
图2 AlOx 基阻变存储器:(a)Ti 帽层结构,(b)N 掺杂AlOx,(c)AlOx/HfOx 异质结阻变机理,(d)超薄AlOx/HfOx 异质结,(e)AlOx/ZnO 异质结,(f)多结渐变阻变存储器结构[9-10,12-14,16]
Fig.2 RRAM based on AlOx materilas:(a)Ti buffer layer,(b)N-doped AlOx,(c)schematic of the switching process in the HfOx/AlOx,(d)ultrathin AlOx/HfOx,(e)AlOx/ZnO heterojunction,(f)schematic diagram of the multilayer RRAM[9-10,12-14,16]
1.3 氧化镍阻变材料
氧化镍的禁带宽带为3.7 eV, 是一种p 型半导体材料,在太阳能电池、薄膜晶体管、气体传感器等领域均有重要的应用。 氧化镍材料是最早用于阻变存储器研究的重要材料之一。 2004 年Baek 等[17]首次报道了氧化镍阻变存储器的开启电压为0.5 V,读写次数达106 次以及优异的稳定性。Yoo 等[18]采用透射电镜原位表征Pt/NiOx/Pt 阻变存储器读写过程中导电细丝的变化, 并证实了氧空位在电场的作用下与Ni 发生氧化还原反应形成Ni 导电细丝,从而引起NiO 薄膜在不同电压下实现高低阻态的转变, 如图3(a)所示。 2010 年Ryoo 等[19]通过在NiOx 薄膜沉积一层Al 缓冲层,加快其高低阻态的转变过程,从而实现低操作电流(0.15mA)。 Nardi 等[20]通过将NiOx 阻变存储器与MOSFET 集成制备(图3(b)),成功将阻变存储器的限制电流控制在10 μA, 较低的操作电流可以保证高密度的RRAM 阵列,如图3(d)所示。 Nardi等[21]进一步通过采用AFM 纳米级探针作为电极,限制导电细丝的宽度,将操作电流减小至100 nA,如图3(c~e)所示。 Ahn 等[22]采用磁控溅射制备多层NiO薄膜,并引入富氧空位NiO0.95 层促进氧空位导电细丝的形成,从而显著降低NiO 基阻变存储器的读写电压。 Ahn 等[23]采用脉冲激光沉积在SrTiO3 衬底制备NiO 纳米点, 并基于AFM 纳米级探针作为电极实现纳米级阻变存储器。尽管该器件性能较差,但其纳米级工艺为NiO 基阻变存储器实现高密度阵列提供了新思路。 Ahn等[24]采用溶液法工艺在Nb 纳米突刺衬底上制备NiO 薄膜,纳米突刺的结构可以在NiO薄膜内部限制局部的导电细丝形成,有利于促进金属导电细丝的形成与断裂,从而显著提升NiO 基阻变存储器性能。 然而由于氧化镍阻变存储器的单极型阻变特性,其开关电压的均一性较差且器件成品率较低,未来的研究工作将围绕氧化镍阻变存储器的均一性和稳定性开展。
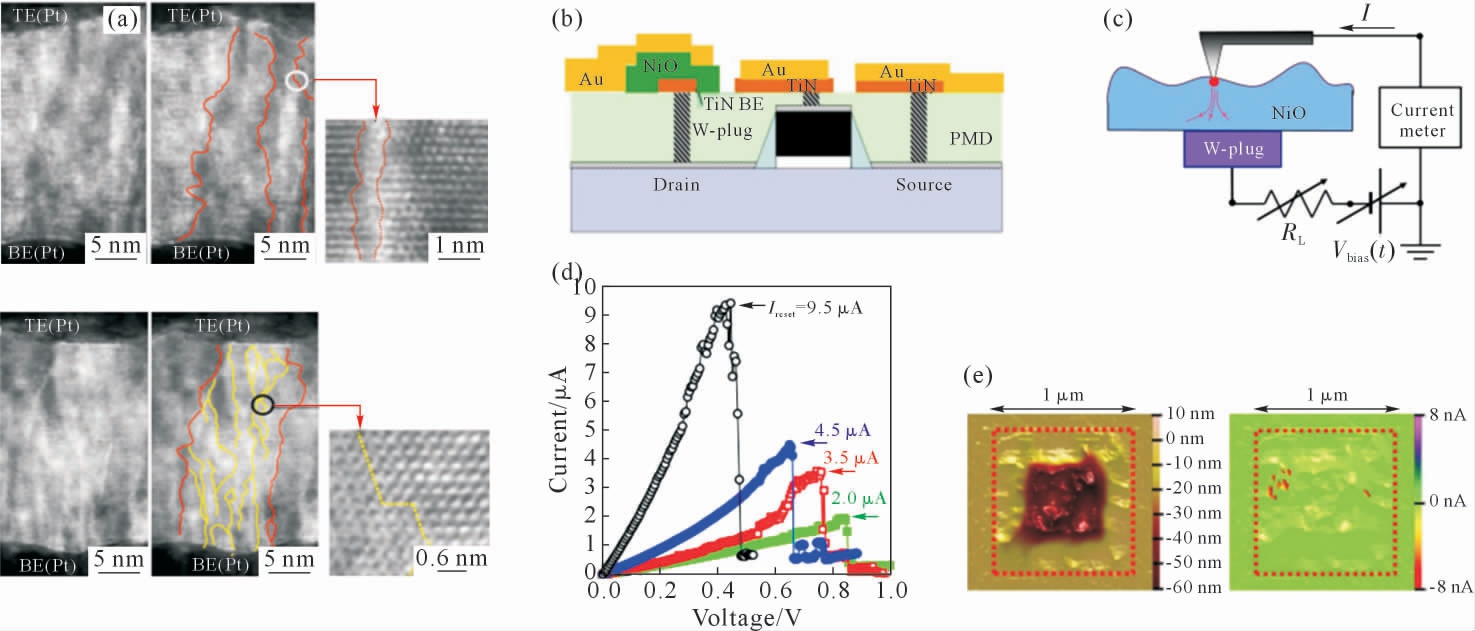
图3 NiOx 基阻变存储器:(a)TEM 图,(b)异质集成,(c)AFM 纳米探针,(d)阻变存储器I-V 特性,(e)导电AFM 表面图[8,20-21]
Fig.3 RRAM based on NiOx materilas:(a)TEM spectra,(b)schematic of the 1T-1R structure,(c)schematic illustration of the CAFM,(d)I-V curves of RRAM,(e)topography map obtained by CAFM[8,20-21]
1.4 二氧化钛阻变材料
二氧化钛材料的禁带宽度约为3.2 eV, 是一种n 型半导体材料,在光电器件领域有着广泛的应用。二氧化钛材料具有相对较高的介电常数(80),远远大于氧化铪材料, 非常适合应用于阻变存储器。2007 年Tsunoda 等[25]采用磁控溅射在Pt 电极上沉积一定厚度的Ti 金属,通过在氧气中高温退火形成TiO2 薄膜,并基于Ag/TiO2/Pt 结构实现双极型阻变存储器。 同时,他们发现阻变存储器的低阻态值与限制电流呈线性关系,低阻态的稳定性与温度有直接关系。 2009 年Yang 等[26]基于原子层沉积生长二氧化钛薄膜, 并采用Cu/TiO2/Pt 结构制备阻变存储器,利用AFM 进一步证实金属Cu 的迁移运动可以调控TiO2 薄膜的阻变特性。 此外,研究者提出TiO2也可以通过利用薄膜中的氧空位迁移来实现阻变特性,Choi 等[27]提出TiO2 薄膜中的氧空位在电场的作用下迁移形成导电细丝,使得其呈现低阻态。 由于焦耳热的作用, 薄膜中的导电细丝会出现断裂,进而转变为高阻态。 目前TiO2 阻变存储器多采用双氧化物层结构或纳米晶引入等手段来实现阻变存储器性能和稳定性的提升。 Ryu 等[28]采用原子层物理沉积制备HfAlOx/TiO2 双氧化物层, 并基于Pt/TiO2/HfAlOx/TiN 结构制备阻变存储器实现了1 mA 低操作电流和双极型阻变特性。 Zhang 等[29]采用磁控溅射在透明柔性ITO 衬底上制备TiO2/HfO2异质结并制备柔性阻变存储器, 提出氧空位与氧离子的协同作用实现阻变开关特性。
1.5 氧化锌阻变材料
氧化锌材料的禁带宽度为3.37 eV,是一种n 型半导体材料。 氧化锌材料因其优异的电学性能和光学性能,被广泛用于电子器件和光电器件的研究。氧化锌材料作为第三代宽禁带半导体材料,一直受到国内外研究的广泛关注,尤其是在阻变存储器方面。北京大学康晋锋教授团队[30]采用磁控溅射法在Pt 电极上沉积ZnO(30 nm)薄膜并在高温下退火实现薄膜的结晶, 基于TiN/ZnO/Pt/Ti/SiO2/Si 结构协同光刻技术制备微米级阻变存储器, 实现了稳定的双极型阻变特性和1.2 V 低开启电压。 Heluani 等[31]采用脉冲激光沉积法在SiN 衬底上生长ZnO 薄膜,通过在氮气氛围下生长诱导本征氧化锌的晶格缺陷,N原子直接参与导电细丝的形成与断裂过程, 从而表现出更优的阻变特性。Lee 等[32]基于Au/ZnO/不锈钢衬底结构制备阻变存储单元, 通过磁控溅射在不锈钢衬底上生长ZnO 薄膜,实现可弯曲的柔性阻变存储器,如图4(a~b)所示。 由于不锈钢衬底具有良好的导电性和导热性,基于不锈钢衬底的柔性氧化锌阻变存储器也表现出良好的柔韧性和延伸性, 如图4(d)所示。 Huang 等[33]通过在单层非晶ZnO 薄膜上溅射沉积CuO 异质结薄膜,并基于Ag/CuO/ZnO/Pt 结构制备阻变存储器(图4(e)),双层氧化物异质结阻变存储器表现出更优的稳定性和循环特性。 Arya Lekshmi 等[34]采用原子层物理沉积制备AlOx/ZnO异质结,并基于Au/AlOx/ZnO/FTO 制备阻变存储器实现了pA 级低操作电流和低开启电压。 Oh 等[35]通过磁控溅射在TaN 表面沉积一层ZnO 薄膜(图4(c)),通过TEM 进一步证实ZnO 与TaN 反应形成一层TaON 薄层, 可有效增加ZnO 薄膜的氧空位浓度,从而显著提升ZnO 基阻变存储器性能。Wu 等[36]基于全无机钙钛矿CsPbBr3/ZnO 薄膜异质结实现双极型阻变存储器件,器件开关比超过105,开启电压小于1 V,且能够实现电致阻变和光致阻变,如图4(f)所示。
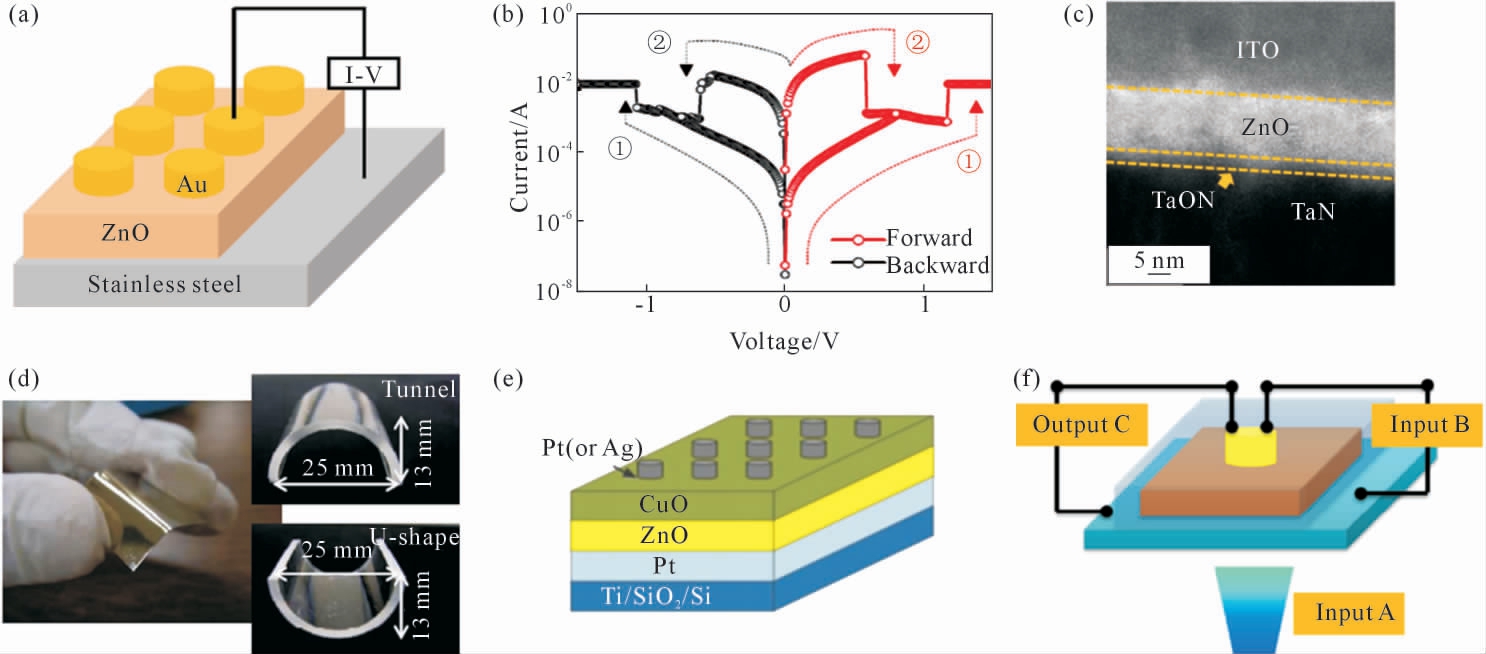
图4 ZnO 基阻变存储器:(a)不锈钢衬底结构阻变存储器,(b)ZnO 基阻变存储器I-V 曲线,(c)TaON 界面层,(d)柔性可弯曲阻变存储器,(e)CuO/ZnO 异质结,(f)逻辑门器件示意图[32-33,35-36]
Fig.4 RRAM based on ZnO materilas:(a)RRAM based on strainless steel,(b)I-V curve of RRAM,(c)TaON interface layer,(d)flexible and bent RRAM,(e)CuO/ZnO heterojunction,(f)schematic of the logic-gate device[32-33,35-36]
1.6 氧化钽
氧化钽材料具有2 种相稳定态,分别是低电阻率的TaO2 和高电阻率的Ta2O5,这也使得其非常适合用于阻变存储器研究。 相比于其他氧化物阻变存储器,氧化钽阻变存储器具有更优的循环稳定性和耐久性。 2008 年曹刚等[37]首次采用0.18 μm 的CMOS工艺制备氧化钽阻变存储器,并实现了循环测试达109 次和超长的保持特性,这结果进一步证实了氧化钽在阻变存储器方面具有较大的应用前景。 2011 年Wei 等[38]进一步采用Ir/Ta2O5/TiOx/TaN结构制备高密度阻变存储阵列, 实现了更优的器件性能和稳定性。 Lee 等[39]采用磁控溅射在Pt 电极上沉积一层较厚的TaO2 材料,然后利用氧等离子处理TaO2 表面形成一层薄的Ta2O5 界面层, 基于该异质结制备的阻变存储器实现ns 级的读写速度和1012 次循环测试,表现出优异的阻变存储特性。2016年Azzaz 等[40]采用物理气相沉积在TiN 电极上制备5nmTaO2和5nmTa2O5材料, 并基于TiN/Ta2O5/TaO2/TiN 结构制备阻变存储器,实现了较低的操作电流(100 μA)以及优异的循环稳定性。 Qin 等[41]通过磁控溅射在Pt 电极上沉积TaOx 薄膜,并通过离子注入的方法实现Al离子原位掺杂,Al 掺杂进一步提升TaOx 薄膜中氧空位浓度, 从而显著提升阻变存储器性能。 2022 年Stecconi 等[42]采用原子层沉积和物理气相沉积制备HfOx/TaOx 异质结薄膜并制备nm 级尺寸的阻变存储器,器件表现出较大的开关比和保持特性,且有望应用于超大规模集成存储阵列。
2 电极材料
电极材料对于阻变存储器的性能有着至关重要的作用, 电极材料通常也会在电场的作用下直接参与阻变介质层的电阻转变过程。 电极材料会直接影响阻变介质材料的氧空位浓度或通过电化学氧化还原反应参与到阻变过程中。 常用的金属材料Au[32]、Ni[11]、Pt[30]、Cu[43]、Al[15]、Ag[34]、Ti[44]等与介质层材料接触较好,能够显著提升器件的导电性或者与氧化物发生反应,从而直接参与介质材料的阻变过程。合金材料作为电极材料亦可以显著提升器件的阻变性能[45]。 常用的氧化物透明电极具有良好的导电性, 也可作为阻变存储器的电极材料[23]。 此外,碳纳米管[46]和硅[47]等材料也可作为阻变存储器的电极材料,如表1 所示。
表1 阻变存储器电极材料[46]
Tab.1 Electrode materials for RRAM[46]

?
2.1 电极的活泼性
金属电极材料的活泼性对于阻变存储器电极的选择至关重要,金属电极的活泼性强弱决定了其捕获氧离子的能力,从而影响阻变存储器性能[44]。当阻变存储器的顶电极和底电极均采用惰性金属时,器件读写状态均是同一电压极性完成,呈单极型阻变。 当顶电极或底电极为活性电极,器件则为双极型阻变存储器。Lin 等[48]采用Pt 电极作为底电极,通过对比Ti、Al、Pt 等不同金属作为顶电极,研究发现采用Ti 作为顶电极时,显著提升了阻变存储器的开启电压和阻变参数的均一性。Zhou 等[49]采用ZrN 作为HfO2 基阻变存储器电极, 研究发现ZrN 材料与氧化物接触在界面形成ZrON 薄膜, 并起到储存氧离子的作用,基于ZrN 电极的器件表现出良好的循环特性和保持特性。Cong 等[50]采用ITO 作为电极材料,其电极材料薄膜内部的氧空位和Sn4+离子作用可以促进氧离子的移动,相比于Pt 电极器件,基于ITO 电极材料的器件表现出低操作电压和低功率。
2.2 电极功函数
阻变存储器的电极选择也要考虑电极功函数,电极和阻变介质层的功函数匹配决定了电极材料与介质层的势垒高度, 从而改变不同金属电极,有效调控阻变存储器的性能。 阻变存储器采用N 型硅作为电极,与阻变介质层形成肖特基势垒,基于硅电极阻变存储器不仅具有良好的阻变特性,还具有自整流效应[47]。 自整流特性的阻变存储器避免了存储整列中的串扰问题, 不需要额外串接整流二极管,有望应用于高密度存储阵列。Chai 等[51]采用碳纳米管材料作为阻变存储器电极,碳纳米管电极材料与介质材料功函数匹配使得器件形成互补型阻变特性,从而消除阻变存储阵列中的漏电问题。
2.3 电阻的接触特性
阻变存储器电极与阻变介质层的接触特性对于器件性能也有重要的影响,接触较好的电极不仅可以提高其导电性,而且能够有效地减少界面接触电阻和器件的漏电流。 Seo 等[52]研究发现当采用金属Pt 或Au 作为顶电极,电极与阻变介质层形成欧姆接触,阻变存储器在小电压下就可以开启。 当采用金属Ti 作为顶电极时,其与阻变介质层形成肖特基接触,器件的开启电压显著增大。Chen 等[3]提出在TiN 与HfOx 层插入一层Ti 金属帽层, 通过金属Ti改善TiN 电极与HfOx 介质层材料的界面接触特性,并通过Ti 缓冲层存储氧离子促进氧空位导电细丝的形成。类似的电极接触特性的改善方法,Lee 等[4]也提出采用AlCu 和Ta 作为电极缓冲层,提升器件性能。Wu 等[9]采用在Al 电极材料和AlOx 介质材料之间插入一层Ti 电极缓冲层,通过高温退火工艺实现界面接触的改善,从而实现超低的操作电流。
3 氧化物阻变机理
3.1 金属电极的氧化还原机制
阻变存储器底电极采用惰性金属电极[11],如Pt、Au、W 等,顶电极采用电化学性质活泼的金属电极[15],如Ag、Al、Ni、Cu 等,在电场的作用下活泼金属电极容易被氧化成金属阳离子进行移动,在底电极处被还原成金属原子,在阻变介质层金属原子的堆积形成导电细丝,进而形成器件的低阻态。 当施加反向电压时,金属离子会沿相反方向移动,金属导电细丝断裂进入器件的高阻态。 Schindler 等[53]针对Ag/Pt 作为上下电极时, 提出随着电场作用增加,Ag 电极发生氧化反应形成Ag 离子并向底电极迁移,当Ag 离子到达底电极时被还原并在电极附件堆积形成Ag导电细丝。 当施加反向电场时,整个过程发生反向氧化还原反应并溶解导电细丝,从而实现介质层材料的阻变开关特性。
3.2 电荷俘获释放机制
氧化物阻变介质层材料在制备的过程中不可避免的存在固有的杂质和缺陷态,这些固有杂质和缺陷态会捕获跃迁的电子,从而实现氧化物材料的阻变特性,目前符合电荷俘获释放机制的阻变模型有Simmons-Verderber(SV)模型[54]、空间电荷限制电流(SCLC)模型[33]和Pool-Frenkel(PF)模型[34]。 根据阻变存储器测试的I-V 曲线拟合, 可以分析符合哪一种电荷俘获释放机制,部分器件并不是符合单一的模型, 在不同电压下符合不同的电荷俘获模型。 Kim等[56]总结了用陷阱控制的空间电荷限制电流模型来解释阻变存储器在高阻态时的导电机制, 并通过I-V 曲线拟合验证了高、低阻态的比值与ZrO2 薄膜材料的缺陷浓度,能级和温度均有关系。 Chang 等[55]基于Pt/ZnO/Pt 结构阻变存储器提出在不同电压下其导电机制符合不同的模型,在低电压时阻变存储器是欧姆传导机制,而在高电压时其又符合PF 发射模型。
3.3 氧空位的电化学反应机制
氧化物材料中有大量的氧空位或氧离子, 在电场的作用下其会向电极一侧迁移,形成氧空位构成的导电细丝;或当氧离子迁移到电极界面处与电极反应形成金属氧化物,导致界面接触改变,进而实现材料的阻变开关特性[57]。
3.4 熔丝与反熔丝机制
氧化物材料存在固有的氧空位或金属离子空位[58],其在电场的作用下快速迁移,能够改变氧化物局部区域的导电性并形成微小导电细丝通道, 使得氧化物材料从高阻变为低阻。 当再次施加同方向的电压时, 之前形成的微小导电细丝会产生大量的热导致导电细丝熔断,进入高阻态。当再次施加同方向的电压时,熔断的导电细丝在电场作用下重新连接,使得器件进入低阻态实现阻变开关特性[59]。 熔丝与反熔丝机制多符合于过渡金属氧化物材料, 大部分过渡金属氧化物材料表现出热化学性质的电阻开关特性。 Yun 等[60]基于Pt/NiO/Pt 结构阻变存储器验证了NiO 薄膜内部导电细丝的连接和熔断过程,并采用导电AFM 直观展示了导电细丝的熔断状态。
4 结论和展望
阻变存储器因其结构简单、 读写速度快, 且与CMOS 工艺兼容等独特的优势,有望应用于新型非易失性存储器和类脑神经计算领域。 金属氧化物材料的制备工艺相对成熟, 且通过光刻技术实现微型化器件和高密度阻变存储阵列, 可应用于感存算一体的存储芯片。 目前, 氧化物基阻变存储器的性能仍有较大提升空间, 高密度低功耗的阻变存储阵列仍是未来信息存储领域的核心。 氧化物材料制备和微纳尺寸器件加工是提升阻变存储器性能的重要方法, 探索器件阻变机制和分析导电细丝的形成与断裂机理是未来基础研究的重要方向。 氧化物基阻变存储器对神经突触和类脑神经计算也具有一定的应用潜力, 未来可与人工智能方向交叉结合实现仿生智能。
[1] PENG B L, LU Q P, WANG Y C, et al. B-Site nanoscale-ordered Structure enables ultra-high tunable performance[J]. Research,2022,2022:9764976.
[2] PARK I S,KIM K R,LEE S,et al.Resistance switching characteristics for nonvolatile memory operation of binary metal oxides[J].Japanese Journal of Applied Physics,2007,46(4):2172-2174.
[3] CHEN Y S, LEE H Y, CHEN P S, et al. Highly scalable hafnium oxide memory with improvements of resistive distribution and read disturb immunity: 2009 IEEE International Electron Devices Meeting(IEDM)[C].Piscataway:IEEE,2009.1-4.
[4] LEE H Y,CHEN P S,WU T Y,et al.HfOx bipolar resistive memory with robust endurance using AlCu as buffer electrode[J].IEEE Electron Device Letters,2009,30(7):703-705.
[5] ISLAM R, QIN S, DESHMUKH S. et al. Improved gradual resistive switching range and 1000 on/off ratio in HfOx RRAM achieved with a Ge2Sb2Te5 thermal barrier[J].Applied Physics Letters,2022,121(8):082103.
[6] PERSSON K M, RAM M S, WERNERSSON L E. Ultra-Scaled AlOx diffusion barriers for multibit HfOx RRAM operation[J].IEEE Journal of the Electron Devices Society,2021,9(4):564-569.
[7] ZHANG Z, WANG F, HU K et al. Improvement of Resistive switching performance in sulfur-doped HfOx-based RRAM[J].Materials,2021,14(12):3330.
[8] LEE H Y, CHEN P S, WU T Y et al. Low power and high speed bipolar switching with A thin reactive Ti buffer layer in robust HfO2 based RRAM: 2008 IEEE International Electron Devices Meeting(IEDM)[C].Piscataway:IEEE,2008.1-4.
[9] WU Y, LEE B, WONG H S P. Al2O3-Based RRAM using atomic layer deposition (ALD) with 1 mA RESET current[J]. IEEE Electron Device Letters,2010,31(12):1449-1451.
[10] KIM W, PARK S I, ZHANG Z P, et al. Forming-free nitrogen-doped AlOXRRAM with sub-μA programming current:2011 Symposium on VLSI Technology-Digest of Technical Papers[C].Piscataway:IEEE,2011.22-23.
[11] SHEN Z, QI Y, MITROVIC I, et al. Effect of annealing temperature for Ni/AlOx/Pt RRAM devices fabricated with solution-based dielectric[J].Micromachines,2019,10(7):446.
[12] YU S M,WU Y,CHAI Y,et al.Characterization of switching parameters and multilevel capability in HfOx/AlOx bi-layer RRAM devices: Proceedings of 2011 International Symposium on VLSI Technology,Systems and Applications[C].Piscataway:IEEE,2011.1-2.
[13] CHEN Y S,CHEN P S,LEE H Y,et al.Enhanced endurance reliability and low current operation for AlOx/HfOx based unipolar RRAM with Ni electrode[J].Solid-StateElectronics,2014,94:1-5.
[14] WU M C,CHEN J Y,TING Y H,et al.A novel high-performance and energy-efficient RRAM device with multi-functional conducting nanofilaments[J].Nano Energy,2021,82:105717.
[15] ISMAIL M, MAHATA C, KIM S. Electronic synaptic plasticity and analog switching characteristics in Pt/TiOx/AlOx/AlTaON/TaN multilayer RRAM for artificial synapses[J]. Applied Surface Science,2022,599(4):153906.
[16] YIN B E, WANG Y Z, XIE G C, et al. Memristors based on TiOx/HfOx or AlOx/HfOx Multilayers with Gradually Varied Thickness[J].Physica Status Solidi-Rapid Research Letters,2021,15(6):2000607.
[17] BAEK I G,LEE M S,SEO S,et al.Highly scalable non-volatile resistive memory using simple binary oxide driven by asymmetric unipolar voltage pulses:EDM Technical Digest.IEEE International Electron Devices Meeting,2004[C].Piscataway: IEEE,2004.587-590.
[18] YOO I K, KANG B S, AHN S E, et al. Fractal dimension of conducting paths in nickel oxide (NiO) thin films during resistance switching[J]. IEEE Transactions on Nanotechnology, 2010, 9(2):131-133.
[19] RYOO K C,OH J H,JUNG S H,et al.Resistive switching characteristics of novel Al-inserted resistive random access memory(RRAM):2010 IEEE Nanotechnology Materials and Devices Conference[C].Piscataway:IEEE,2010.356-359.
[20] 额日特. 基于NiO 阻变存储器电学性能提升的研究[D]. 天津:天津理工大学,2013.E R T. Study on improvement of resistive switching performance based on the NiO RRAM cells[D].Tianjin:Tianjin University of Technology,2013.
[21] NARDI F,DELERUYELLE D,SPIGA S,et al.Switching of nanosized filaments in NiO by conductive atomic force microscopy[J].Journal of Applied Physics,2012,112(6):064310.
[22] AHN Y,SON J Y.Resistive random access memory characteristics of NiO thin films with an oxygen-deficient NiO0.95 layer[J].Ceramics International,2021,47(7):9342-9346.
[23] AHN Y,SON J Y.Thickness scaling effects of self-assembled NiO nanodots on resistive switching characteristics[J]. Journal of Alloys and Compounds,2021,872:159666.
[24] AHN Y,SHIN H W,LEE T H,et al.Effects of a Nb nanopin electrode on the resistive random-access memory switching characteristics of NiO thin films[J].Nanoscale,2018,10(28):13443-13448.
[25] TSUNODA K,FUKUZUMI Y,JAMESON J R,et al.Bipolar resistive switching in polycrystalline TiO2 films[J]. Applied Physics Letters,2007,90(11):113501-113503.
[26] YANG L,KUEGELER C,SZOT K,et al.The influence of copper top electrodes on the resistive switching effect in TiO2 thin films studied by conductive atomic force microscopy[J].Applied Physics Letters,2009,95(1):833-110.
[27] CHOI B J,JEONG D S,KIM S K,et al.Resistive switching mechanism of TiO2 thin films grown by atomic-layer deposition[J].Journal of Applied Physics,2005,98(3):1-10.
[28] RYU H,KIM S.Gradually modified conductance in the self-compliance region of an atomic-layer-deposited Pt/TiO2/HfAlOx/TiN RRAM Device[J].Metals,2021,11(8):1199.
[29] ZHANG R,HUANG H,XIA Q,et al.Role of oxygen vacancies at the TiO2/HfO2 interface in flexible oxide-based resistive switching memory[J].Advanced Electronic Materials,2019,5(5):1800833.
[30] XU N, LIU L F, SUN X, et al. Bipolar switching behavior in TiN/ZnO/Pt resistive nonvolatile memory with fast switching and long retention[J].Semiconductor Science and Technology, 2008,23(7):128-131.
[31] HELUANI S P,BRAUNSTEIN G,VILLAFUERTE M,et al.Electrical conductivity mechanisms in zinc oxide thin films deposited by pulsed laser deposition using different growth environments[J].Thin Solid Films,2006,515:2379-2386.
[32] LEE S,KIM H,YUN D J et al.Resistive switching characteristics of ZnO thin film grown on stainless steel for flexible nonvolatile memory devices[J].Applied Physics Letters,2009,95(26):13-16.
[33] HUANG Y, SHEN Z, WU Y et al. CuO/ZnO memristors via oxygen or metal migration controlled by electrodes[J].AIP Advances,2016,6(2):025018.
[34] J A L,T N K,K B J.The effect of the top electrode on the switching behavior of bipolar Al2O3/ZnO RRAM[J].Microelectronic Engineering,2021,250:111637.
[35] OH I,PYO J,KIM S.Resistive switching and synaptic characteristics in ZnO/TaON-Based RRAM for neuromorphic system [J].Nanomaterials,2022,12(13):2185.
[36] WU Y, WEI Y, HUANG Y et al. Capping CsPbBr3 with ZnO to improve performance and stability of perovskite memristors[J].Nano Research,2017,10(5):1584-1594.
[37] 曹刚.基于简单氧化物的忆阻特性及神经突触的研究[D]. 保定:河北大学,2021.CAO G. Research on the characteristics of memristors and neurosynapses based on simple oxides[D].Baoding:Heibei University,2021.
[38] WEI Z, TAKAGI T, KANZAWA Y, et al. Demonstration of high-density ReRAM ensuring 10-year retention at 85 ℃based on a newly developed reliability model[J].Electron Devices Meeting,2011:721-724.
[39] LEE M J,LEE C B,LEE D,et al.A fast,high-endurance and scalable non-volatile memory device made from asymmetric Ta2O5-x/TaO2-x bilayer structures[J].Nature Materials, 2011,10(8):625-630.
[40] 黄勇.氧化锌基薄膜阻变存储器件的制备及性能研究[D]. 南京:南京理工大学,2019.HUANG Y.Research on resistive switching memory based on zinc oxide film[D].Nanjing: Nanjing University of Science and Technology,2019.
[41] QIN Y,WANG Z,LING Y,et al.A TaOx-Based RRAM with improved uniformity and excellent analog characteristics by local dopant engineering[J].Electronics,2021,10(20):2451.
[42] STECCONI T, POPOFF Y, GUIDO R, et al. Equivalent electrical circuit modelling of a TaOx/HfOx based RRAM with optimized resistance window and multilevel states: 2022 IEEE Device Research Conference[C].Piscataway:IEEE,2022.1-2.
[43] KIM T H, KIM S, PARK B G. Improved rectification characteristics by engineering energy barrier height in TiOx-based RRAM[J].Microelectronic Engineering,2021,237:111498.
[44] HU R, LI X, TANG J, et al. Investigation of resistive switching mechanisms in Ti/TiOx/Pd-Based RRAM devices[J]. Advanced Electronic Materials,2022,8(8):1-7.
[45] JANG J,SUBRAMANIAN V.Effect of electrode material on resistive switching memory behavior of solution-processed resistive switches: Realization of robust multi-level cells[J]. Thin Solid Films,2017,625:87-92.
[46] 吴加吉. 不同电极材料下氧化物阻变存储器性能及机理的研究[D].武汉:湖北大学,2017.
[47] RODRIGUEZ-FERNANDEZ A,ALDANA S,CAMPABADAL F,et al. Resistive Switching with Self-Rectifying Tunability and Influence of the Oxide Layer Thickness in Ni/HfO2/n+-Si RRAM Devices[J].IEEE Transactions on Electron Devices, 2017,64(8):3159-3166.
[48] LIN C Y,WU C Y,WU C Y C Y et al.Effect of top electrode material on resistive switching properties of ZrO2 film memory devices[J].IEEE Electron Device Letters,2007,28(5):366-368.
[49] ZHOU Q,ZHAI J.HfOx bipolar resistive memory with robust endurance using ZrNx as buttom electrode[J].Applied Surface Science,2013,284:644-650.
[50] YE C, ZHAN C, TSAI T M et al. Low-power bipolar resistive switching TiN/HfO2/ITO memory with self-compliance current phenomenon[J].Applied Physics Express,2014,7(3):034101.
[51] CHAI Y, WU Y, TAKEI K et al. Nanoscale bipolar and complementary resistive switching memory based on amorphous carbon[J].IEEE Transactions on Electron Devices, 2011, 58(11):3933-3939.
[52] SEO S, LEE M J, KIM D C et al. Electrode dependence of resistance switching in polycrystalline NiO films[J]. Applied Physics Letters,2005,87(26):1-3.
[53] SCHINDLER C, MEIER M, WASER R et al. Resistive switching in Ag-Ge-Se with extremely low write currents:2007 Non-Volatile Memory Technology Symposium[C].Piscataway:IEEE,2007.82-85.
[54] CHEN A.Electronic effect resistive switching memories:Emerging NanoelectronicDevices[M].NewYork:JohnWileyandSonsLtd.,2014.
[55] CHANG W Y,LAI Y C,WU T B,et al.Unipolar resistive switching characteristics of ZnO thin films for nonvolatile memory applications[J].Applied Physics Letters,2008,92(2):1-4.
[56] KIM K M, JEONG D S, HWANG C S. Nanofilamentary resistive switching in binary oxide system; a review on the present status and outlook[J].Nanotechnology,2011,22(25):254002.
[57] PARK C,JEON S H,CHAE S C,et al.Role of structural defects in the unipolar resistive switching characteristics of Pt/NiO/Pt structures[J].Applied Physics Letters,2008,93(4):042102.
[58] LIM D H,KIM G Y,SONG J H,et al.Filament geometry induced bipolar,complementary and unipolar resistive switching under the same set current compliance in Pt/SiOx/TiN[J].Scientific Reports,2015,5(1):15374.
[59] CHANG W Y,LAI Y C,WU T B,et al.Unipolar resistive switching characteristics of ZnO thin films for nonvolatile memory applications[J].Applied Physics Letters,2008,92(2):1-4.
[60] YUN J B, KIM S, SEO S, et al. Random and localized resistive switching observation in Pt/NiO/Pt[J].Physica Status Solidi-Rapid Research Letters,2007,1(6):280-282.